PCB 有了新的故事... ...

什么是 CoWoP 封装?
CoWoP(Chip on Wafer on PCB)是一种创新的系统级封装技术。它先将裸芯片(Chip)通过微凸点倒装到硅中介层(Wafer)上,完成芯片与硅基板的高密度互连;然后将整个 “芯片在硅片” 组件直接键合到多层 PCB 上,省去传统有机封装基板。PCB 在此不仅承担电连接,还通过 HDI 或 MSAP/SAP 等工艺在板上形成精细的重分布层(RDL),保证信号完整性与功率分配。
相比传统封装,CoWoP 将封装 substrate 与 PCB “一体化”,实现了更薄、更轻、更高带宽的模块设计,同时充分利用大尺寸 PCB 产线的高产能与成熟工艺。它用成熟大面板 PCB 替代昂贵的 ABF/BT 封装 substrate,不仅大幅降低了材料与制造成本,还依托 PCB 产线的高产能与短交付周期实现更快的量产;同时通过在 PCB 上直接集成裸芯片、硅中介层和多层 HDI/MSAP 重分布层来减少封装层级,实现更薄更轻的板卡一体化设计,并在同一板上完成多至十余层、30 µm 级线宽 / 线距的高速互连,兼具高带宽、低延迟与设计灵活性。
在 AI 加速卡中,CoWoP 可将 GPU/TPU 裸芯片与 HBM 存储裸堆直接扇出到 PCB 载板以实现 Tb/s 级带宽;在 CoPackaged Optics 光模块中,可将硅光子芯片与驱动 IC 同步封装以降低电 / 光转换损耗;在高端网络设备中,能让 ASIC 或 FPGA 裸片扇出至 PCB 完成高速 SerDes 互联;在汽车电子与 ADAS 中,可将高性能 MCU、雷达芯片和射频前端封装于 PCB 以满足高可靠性需求;此外,它也可用于智能手表和 AR/VR 终端中,将 SoC、传感器与电源管理芯片高度集成于超薄 PCB 载板上。
产业链相关公司:胜宏科技、沪电股份、兴森科技、深南电路、鹏鼎科技等。
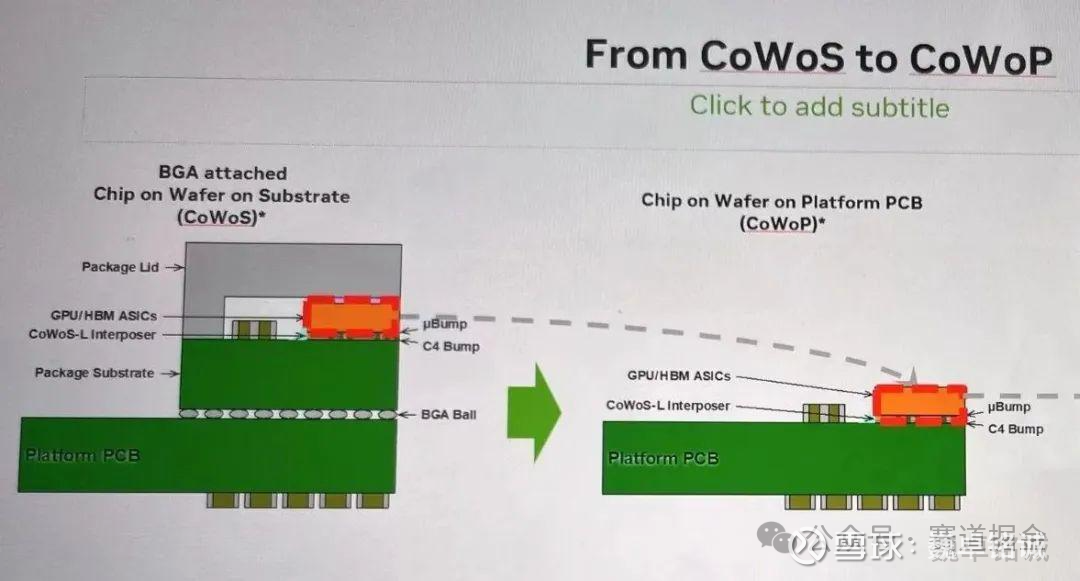
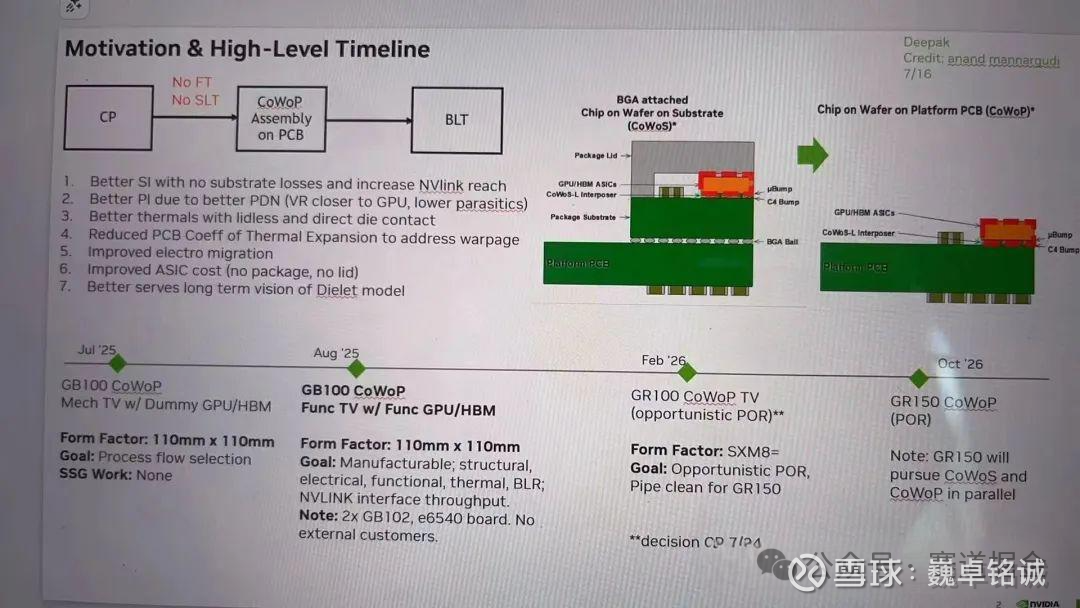
NVPCB最新变化交流要点:
1️⃣NV将在rubinultra上考虑新方案,使用cowop工艺,将芯片直接封装在PCB上。新方案将在oam上下增加载板(或玻璃基板、陶瓷基板),oam从HDI升级到msap工艺。新方案相当于pcb和载板二合一,会把单独的载板替掉。载板、玻璃基板、陶瓷基板三种方案并行。
2️⃣产业进展:欣兴没做出来,沪电和兴森已立案参与。胜宏深度参与,深南后续会加入。
关注标的:
1️⃣新方案参与厂商:胜宏科技、兴森科技、沪电股份、深南电路
传:
1️⃣cowop工艺,即用pcb替代cowos,芯片可以直接封装到PCB上,对PCB的要求可能会上到mSAP工艺;
2️⃣正交背板有可能走mSAP工艺。
MSAP 工艺厂商梳理
胜宏科技:正交背板供应商之一,具备高端HDI加工能力
东山精密:正交背板供应商之一,最高10亿美金扩产在即
深南电路:具备载板和PCB技术能力,正交背板方案接触中
景旺电子:载板产能持续推进,珠海工厂具备SLP能力,已攻入N客户供应链
鹏鼎控股:具备量产SLP能力,mSAP技术强
AI铜箔+AI电子布,又有新催化,持续高景气【国金建材新材料】
1️⃣关注CoWoP新工艺。
2️⃣RTF铜箔提价验证hvlp高景气,近期中国台湾铜箔企业上调rtf价格,判断原因是切换产能生产hvlp、导致rtf偏紧。
3️⃣我们持续看好铜箔+电子布2个领域,结合供给格局+下游技术路线,继续挖潜PCB上游新材料。高端PCB板用电解铜箔包括RTF铜箔和HVLP铜箔,HVLP粗化面平滑、细腻,具有高的热稳定性、高硬度、厚薄均匀,其对铜箔表面轮廓度(Rz)要求更高,可用于生产高频高速CCL。HVLP铜箔生产难度体现在需同时满足低轮廓度与高抗剥离强度。
4️⃣我们认为,电子布的市场研究较为充分,而同属高端PCB原材料的高阶铜箔材料,具备同样持续升级、高端紧缺的属性,我们认为铜箔预期差仍然较大:
高阶铜箔国产化率偏低,国内龙头先发优势可能更突出;
铜箔和电子布均是促进电性能的重要材料,如果二代低介电供给端较为紧缺,可能会加速HVLP铜箔代数升级。同步看好low-dk和q布、cte的龙头优势。相关标的铜冠铜箔、中材科技、菲利华、德福科技、宏和科技。
算力 PCB供应紧张,WAIC2025核心受益板块
WAIC2025大模型/AI应用/GPU集群利好频发:
昇腾超节点CM384;
算力需求持续增长,GPU/ASIC/800G交换机等推动高端AIPCB需求爆发式增长。
持续看好PCB作为算力GPU/Asic核心环节,产业链投资机会:
1️⃣AIPCB新秀:鹏鼎控股(GB300新增核心标的,AIPCB产能Capex上调至40e,FPC利润40-50亿+硬板PCB利润弹性10亿以上)
再更新【天风电新】lowcte&dth
近期,市场传cowop工艺,即用pcb替代cowos,芯片可以直接封装到PCB上,对PCB的要求可能会上到mSAP工艺等。尽管市场在交易在一些远期逻辑,但我们确实看到了上游一些细分的放量和投资机会,对ccl上游,对应的就是lowcte和dth。
1️⃣lowcte
【宏和】是国内大陆龙一:另外三家的主要在干的事通过Q布弯道超车,而宏和是扎根在了二代布和lowcte。lowcte持续爆发(从6月开始的),预计宏和5月5w平、6月10w平、到7月单月已20w,明年或200w平/月,为7月的10X。我们预计明年单月行业需求在300w平/月,根据专家口径,宏和目标200万平/月,会有所夸张。但总体景气度趋势判断没有问题,前期三菱瓦斯(全球最大的bt几板材料供应商)也宣布,因lowcte材料等短缺而发货延迟,且单价跟现在的二代差不多,均为200元。
2️⃣dth
海外巨头三井的产能为2wt(hvlp、dth共线),而公司看中dth,6月电话会明确表示优先扩dth,对整体铜箔业务roic的指引也是24、27、29年分别为27、39、49%,核心认为dth盈利好,重心都在这里。
投资角度:
1️⃣日本不是不扩产,是没有把心思放在hvlp,给大陆供应链做hvlp的机会;而同时向下跟锂电箔企业相比,从ht到rtf到hvlp再到dth,是非常严格的产品迭代,没办法弯道超车。因此看好当前时间点,hvlp的供应链壁垒(设备、客户、产品迭代三个层面),最看好台光、生益链的-【铜冠铜箔】,其次斗山链-【德福科技(卢森堡)】。
2️⃣看好三井dth专利快要到期,国内两家企业也有dth产品布局,往后看继续稳扎稳打,产品升级,做大做强。
PCB产业升级,继续强推板块龙头+上游设备
1️⃣Cowop:
传统的cowos是将芯片封装在ABF载板上,载板再搭载到PCB上实现信号互联;
区别于cowos,cowop直接将芯片封装于PCB板,无需ABF载板,可直观理解为载板与PCB融合;
该方案省略原有载板,减少信号损耗,拥有更好的电源完整性及散热性能,同时可以降本,为未来重要的PCB路线演进方向;
该方案核心是载板工艺(SAP/mSAP)及PCB工艺(HDI/高多层)的融合,具备相关技术储备的公司核心受益。
2️⃣mSAP:
即类载板,加工工艺/线宽线距介于HDI及载板之间,之前多用于面积小但对信号传输要求高的场景,如苹果手机主板、800g/1.6T光模块;鹏鼎、深南等公司均具备成熟的量产经验。
投资建议:我们维持周末给您汇报的观点不变。继续重视PCB龙头公司:胜宏/深南/鹏鼎/沪电等。此外,PCB厂商持续扩产,设备公司弹性更大,重点关注PCB设备厂商芯碁微装+大族数控,其中芯碁微装的LDI设备是mSAP工艺的核心设备。
北美算力 PCB:多维度看AI,怎能不AI?
行业大势:
GPT5大模型即将发布,ASIC用量大幅提升,AI模型能力提升及成本下降在接下来几个季度同步出现,Agent等新应用有望快速渗透。AI时代的AI服务器&交换机好比移动互联网时代的智能机,AI芯片不再是基础设施,而是人人标配的类消费品。
市场规模:技术工艺高多层->HDI->MSAP不断迭代升级,背板、载板等新应用场景不断涌现,25-27年市场规模从500e跃升至2000e左右。
竞争格局:
PCB产业十年未有之大变局,产能稀缺产能为王时代,海外PCB大厂加速衰落,国内大厂迅速崛起,市场将进入强者恒强阶段,紧盯头部PCB玩家。
底层逻辑:流水的芯片,铁打的PCB,技术跟随主芯片不断迭代升级,价值量持续通胀。
景旺电子:坐拥双百亿高端产能,搭乘NV发展快车,若错过胜宏,岂能再错过景旺?
胜宏科技:NV供应链的王者,ASIC时代仍有望再赢一次。强者恒强,未来至少5年PCB的王者。
东山精密:NV背板+光模块同步布局,公司能否在AI时代实现类果链时代的逆袭?
生益科技:周期与成长共振,M8时代的追赶者,M9时代平起平坐。高端CCL产业核心是配方,公司厚积薄发,一旦开启,能够进入长达上十年的成长。
生益电子:ASIC最纯正标的,扩产提速打破产能桎梏,业绩继续狂奔。
沪电股份:GPU/ASIC/800G等高端产品雨露均沾,英伟达/四大云厂的铁杆供应商,10年未有之大扩产,更换引擎迎接AI时代。