12月题材前瞻:先进封装

博通在12月12号电话会议承认:先进封装(CoWoS、多芯片封装)正在成为关键约束,他们在新加坡建设先进封装产能,目的不是为了降成本,而是为了“供应链安全与交付确定性”。今天就科普一下“先进封装”,以及A股市场上哪些公司参与了这个环节。
先进封装:让芯片“积木”搭出未来算力
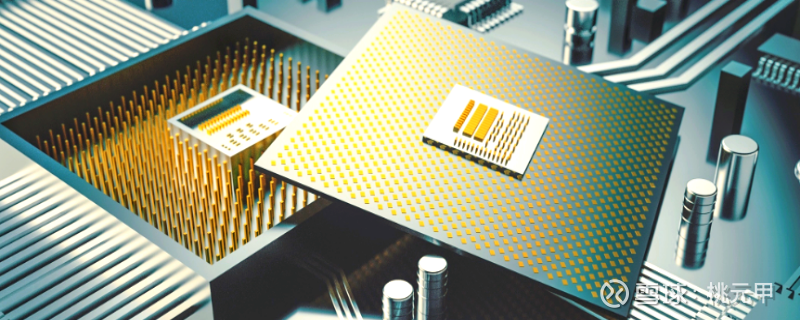
当晶体管微缩逼近物理极限,芯片性能突围的希望被“封装”悄悄托举。所谓先进封装,就是把多颗芯粒(Chiplet)像搭积木一样精准拼接,用更短、更密的互连线取代传统 PCB,实现性能、功耗、面积的黄金平衡。其中,CoWoS(Chip-on-Wafer-on-Substrate)把逻辑芯粒与高频内存并排压在硅中介层上,英伟达 GPU 借此将 HBM 带宽推高至 TB/s;多芯片封装(MCP)则把 CPU、I/O、射频等异构单元一次性塑封,苹果 M 系列正是凭此拿下轻薄笔电的能效桂冠。

技术路线百花齐放:2.5D 硅中介层、3D 微凸块、混合键合、RDL 重布线……每一微米间距的缩小,都在改写算力密度。据测算,全球 AI 服务器拉动的键合设备市场将从 2023 年的 78 亿元翻倍至 2025 年的 156 亿元,而国产设备渗透率尚不足 5%,巨大的供需缺口让 A 股公司迎来黄金窗口。
设备端:
(1)拓荆科技率先实现混合键合与熔融键合量产,打入先进存储、CIS 供应链。
(2)快克智能攻关 TCB 热压键合,目标锁定 HBM3 多层堆叠,2025 年即将送样。
(3)迈为股份跨界光伏精密制造,晶圆级混合键合、临时键合、D2W TCB 全线覆盖,已获多家封测厂验收。
(4)芯源微则推出兼容 60 μm 厚胶的临时键合机,专为 Chiplet 流程定制,订单开始放量。

封测端:
(5)长电科技、通富微电、华天科技三大龙头持续加码 2.5D/3D 产线,国产“集团军”已现雏形。
从设备到工艺,先进封装正成为 A 股半导体板块最具弹性的赛道,也为国产算力打开超越摩尔定律的新大门。