德邦科技精彩亮相SEMICON China 2026 携先进封装材料赋能半导体产业高质量发展

3月25-27日,全球半导体行业年度盛会SEMICON China 2026在上海新国际博览中心隆重举办。当下HPC与AI技术飞速发展,下游应用需求持续攀升,推动半导体产业不断突破性能瓶颈;步入后摩尔时代,先进封装成为承接AI算力需求的核心突破口,Chiplet、CPO、异构集成等技术成为本届展会核心焦点。随着晶圆制程持续精进、先进封装可靠性要求不断提升,半导体封装材料的核心战略地位愈发凸显。
作为半导体封装材料领域的核心企业,德邦科技重磅亮相本次展会,聚焦半导体芯片封装领域,全方位展示创新技术与一站式解决方案,产品覆盖晶圆级、芯片级、板级、系统级封装与组装全品类材料,吸引了行业内众多TOP客户、优质服务商、专业媒体及终端企业驻足观摩、深度交流,其展出的先进封装系列材料更是成为展会关注焦点。

全流程产品布局 覆盖先进封装全场景
德邦科技本次展出的先进封装材料,全方位覆盖晶圆保护和键合、芯片封装与热管理全流程,精准适配WLP、2.5D、3D等主流先进封装工艺,为半导体制造提供一站式材料解决方案,有效破解先进封装工艺痛点,助力产业提质增效。
晶圆级封装材料:筑牢晶圆加工防护屏障
在晶圆级封装环节,德邦科技推出多款核心材料,保障晶圆加工精度与良率。其中,UV减薄膜、UV划片膜专为晶圆减薄与切割工艺打造,具备强力支撑性能,可有效防止晶圆崩边、掉片,经UV照射后能快速减粘、轻松剥离,大幅提升晶圆加工良率;TBH、TBL系列临时键合胶,为超薄晶圆减薄、TSV露出、Cu柱研磨等关键工艺提供可靠临时支撑,可耐受CMP、蚀刻等严苛制程环境,解键合分离快速便捷,全方位保护晶圆完整性。

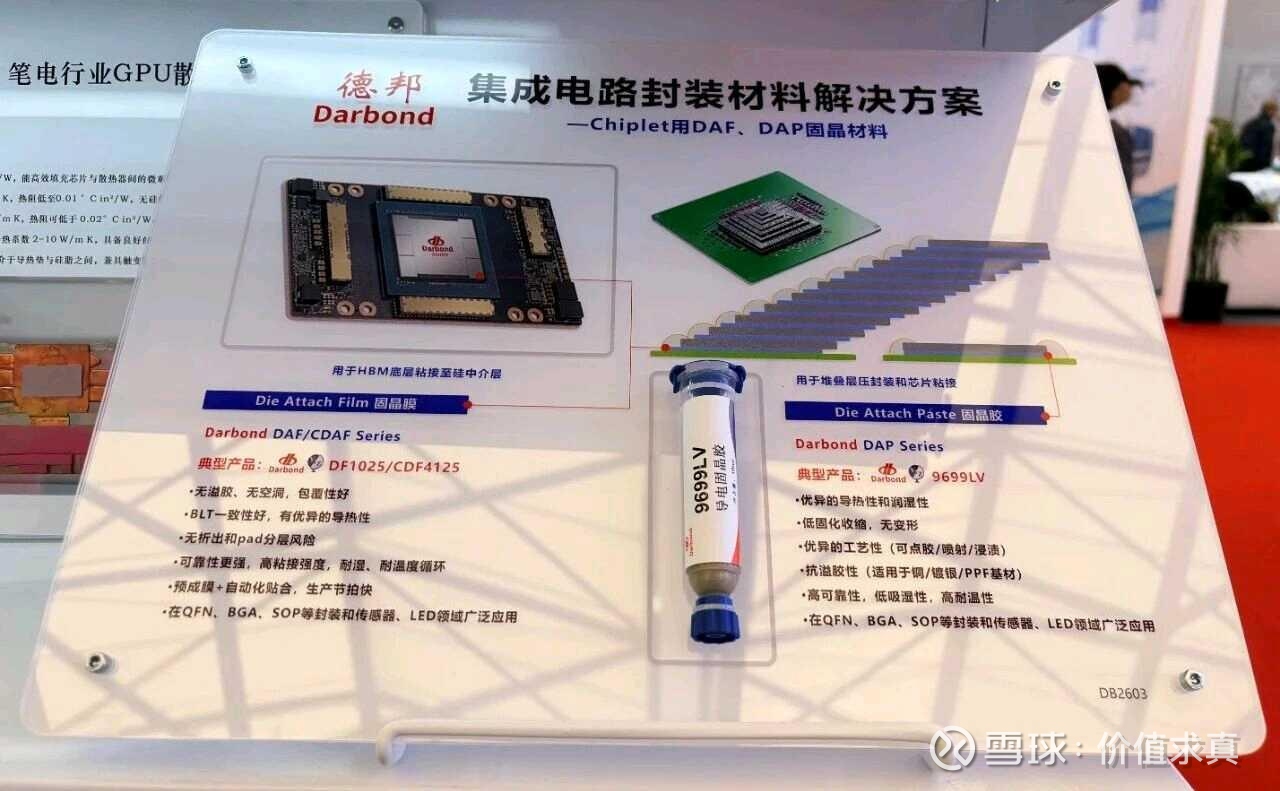
芯片级封装材料:适配高端封装量产需求
芯片封装材料板块,德邦科技多款产品精准匹配大尺寸、2.5D/3D堆叠等高端封装量产刚需。翌骅固晶胶(DAP/CDAP)与固晶膜(DAF/CDAF),可实现切割固片不散片,完成芯片与基板的永久粘接,完美适配3D堆叠封装,显著提升封装可靠性与稳定性;Underfill 6568系列底部填充胶具备快速固化、高效缓冲应力的特性,Dam&Fill 6557系列一体化封装胶拥有强效抗形变、防潮防损的优势,全面满足高端封装场景需求;DM系列LMC液态环氧塑封料,可应用于Fan-out、HBM封装工艺,具备低翘曲、流动性优异的特点,为先进封装提供优质塑封防护。
热管理材料:保障AI算力器件稳定运行
针对AI、HPC、GPU及数据中心等高算力场景的散热需求,德邦科技打造全方位热管理解决方案。PTIM1 6374材料可有效填充芯片与散热盖之间的微小间隙,大幅降低界面热阻,提升散热效率;PTIM1.5 DHG600、Fill-PCM 800材料适用于无散热盖裸片封装,能够减少热传递层级,强化散热效果,为高性能AI计算GPU稳定运行提供坚实保障。
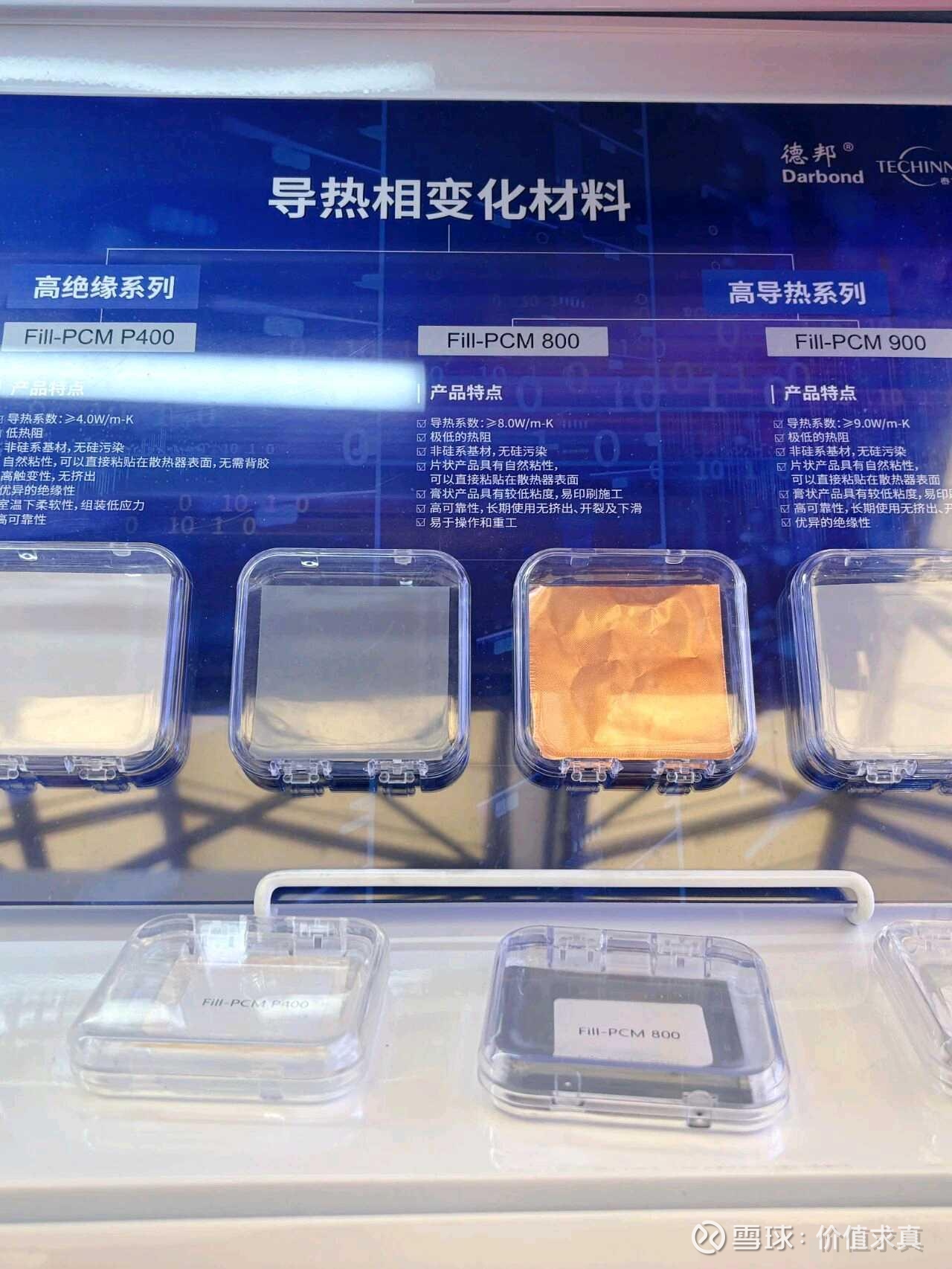
深耕技术创新 助力产业升级与可持续发展
在半导体产业链关键环节,德邦科技始终坚持自主研发与技术创新,凭借优异的材料性能,精准对接行业发展需求,持续为半导体制造提供高可靠性、高效便捷的材料解决方案,全面提升芯片制造良率与可靠性,助力我国半导体产业实现高质量发展。
立足产业前沿,洞察行业趋势,面对持续迭代的技术变革与多元化市场需求,德邦科技坚守创新初心,深耕材料底层技术研发,以高可靠性、绿色化、高效能的材料解决方案,精准破解行业工艺痛点,赋能电子全产业链升级。未来,德邦科技将持续深耕中国市场,不断探索前沿材料应用,携手行业伙伴共筑安全、可持续的半导体产业新生态,共赴产业高质量发展新征程。

