从产品与催化的角度看ASMPT
近期芯片市场的涨价如火如荼,大家对于AI需求拉动的逻辑自然已不再陌生,可背后的稀缺与产能扩张也值得重视,,本文想以产品与催化的角度简单的记录我对ASMPT的看法。$ASM 太平洋(00522)$
一、做什么
ASMPT的业务主要包括①把封装好的设备贴到PCB上的SMT业务 ②先进封装设备的semi业务。营收占比情况如下

可以看出近些年semi(半导体解决方案)的占比不断提升,已经成为公司的中流砥柱,且考虑到Smt业务正在被拆分/出售,所以我们这里重点讨论Semi业务以及产品。
公司正在逐步转型为一家先进封装设备公司。如果说传统封装是为了保护芯片、提供连接,那么先进封装就是通过更高效、紧凑、灵活的方式连接,从而提升整体性能。可以说,在AI驱动与光刻机物理极限的今天,需求+结构变化使得封装已经从过去的装修队变成今天的制造商。
AI的催化
AI带来的催化除了需求的增长,也有结构方面的升级。目前芯片朝着 “更大尺寸、更高集成度”前进,其系统复杂度提升、封装体积更大。但是光刻机的光罩面积已经接近物理极限很难满足下一代,需要封装通过多光罩拼接把可制造的芯片推到光罩尺寸极限之外,从而更紧密地集成以满足AI 驱动的爆发式需求。

那么,公司在其中扮演怎样的角色?
二、产品与角色
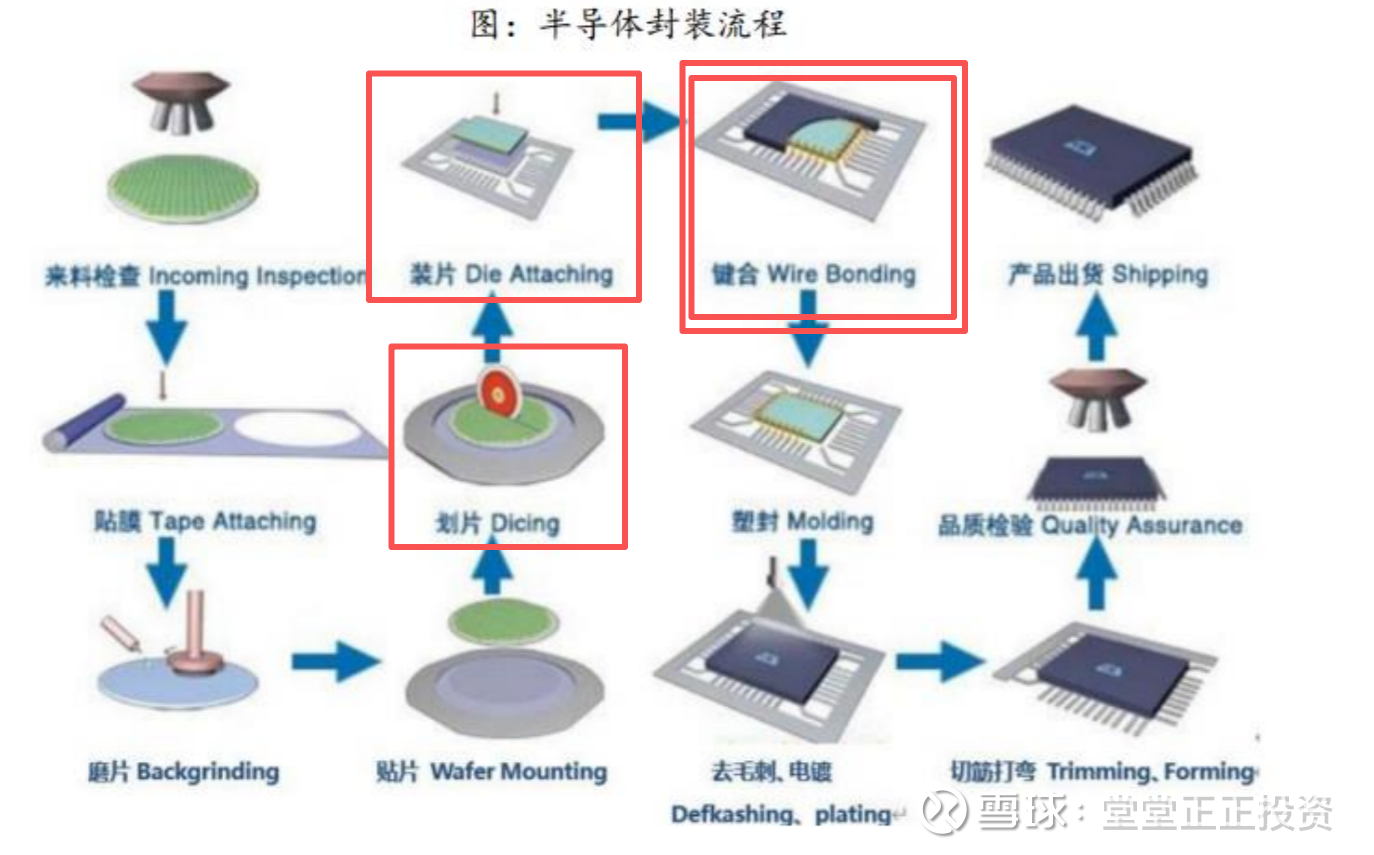
在半导体封装的流程中,公司几乎都有布局,且在划片、装片以及键合(尤其)业务方面有突出优势。
①划片
划片是通过激光实现晶圆的精准开槽与芯片分离,目前芯粒尺寸小、数量多,hbm堆叠多且单片厚度薄,划片设备对于良率有直接的影响。

多光束激光技术(左),是公司设备的一个关键专利,能将一个高功率激光拆分为多个低能量光斑,避免产品损伤、热影响区极小(下图可见),返工成本低。这对于现在要求越来越高先进封装很有意义,且传输技术设计更优、效率高、长期运行稳定、维护少、耗材更换频率极低。(from-公司营销主管 Patrick Huberts近期的采访)

②键合
键合可以算是芯片中的焊接机,用热压键合(TCB)或混合键把内存、芯粒等模块精准 “焊” 在一起,以满足 AI 芯片的高算力需求。没有它,HBM 的多层堆叠、Chiplet 的异构集成都无法实现。而公司的优势则是
1,精度于与稳定性强。TCB 键合精度达 ±1μm,良率高。设备内置的洁净环境标准,几乎可以直接适配hbm或者先进封装需求,无需厂区环境改造,稳定性强。


2,市占率与合作优势。公司占据TCB 35%–40%的市场份额。公司预计TCB 潜在市场将于 2027 年突破 10 亿美元,2024-2027 年复合增长率超 45%,市占率全球第一。且是台积电CoWoS-L TCB设备的唯一供应商,率先获得HBM4 12层封装的TCB订单。
总的来说,精度、稳定性是他的技术优势,全链路布局协同与合作优势是他的特点。但不论如何这些都指向了一个东西——更高的效率。英伟达黄仁勋也表达过类似的观点,表面上看英伟达的芯片是贵的,但是它的产出效率更高,用户的单位成本是更低的。
三、催化
回到市场来说,无论是台机电正在上调的资本开支还是存储厂商跃跃欲试的建厂需求。都使得公司作为一个卖铲人近水楼台先得月。

与此同时,海力士今日公布最强业绩至19.2万亿韩元,超出分析师平均预期的16.7万亿韩元。这是否会带来进一步的产能加速推进从而带来更高的资本开支?开支-订单、需求-结构,正向的螺旋似乎还未停止。